2023-11-13 10:51:41 西盟科技资讯
【华为公布半导体封装专利】
随着全球电子制造业的快速发展,半导体封装技术已经成为制约整个行业发展的关键因素之一。近日,天眼查显示,华为技术有限公司“半导体封装 ”专利公布,申请公布日为 10 月 31 日,申请公布号为CN116982152A。

专利摘要显示,本公开涉及一种半导体封装,该半导体封装包括:第一衬底、半导体芯片、引线框和密封剂。

该专利的公布是华为在半导体领域不断努力的结果。随着全球半导体市场的竞争越来越激烈,华为在半导体技术方面的投入也在不断增加。这项专利的获得, 不仅为华为在半导体封装领域的技术实力提供了有力的证明,也为华为在未来半导体市场的发展提供了重要的支撑。
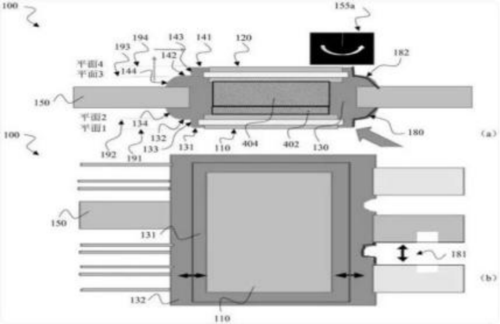
【后摩尔时代,先进封装市场增速领先整体封装市场】
随着半导体工艺制程持续演进,晶体管尺寸的微缩已经接近物理极限,芯片制造良率和成本、芯片功耗及性能也越来越难以平衡,集成电路行业进入“后摩尔时代 ”。
先进封装技术能在不单纯依靠芯片制程工艺突破的情况下,通过晶圆级封装和系统级封装提高产品集成度实现功能多样化,满足终端需求并降低成本,成为后摩尔时代提升芯片整体性能的主要路径。带有倒装芯片结构的封装、晶圆级封装、2.5D/3D 封装等均属于先进封装。

根据 Yole 数据,预计全球先进封装市场将从 2021 年的 340 亿美元增长到2027 年的 620 亿美元,复合增速 11%。对比 2020-2026 年全球封装市场年复合增长率约为 6%,并在 2025 年占据整体封装市场的 49.4%。根据鼎龙股份公告中引用的华经产业研究院数据,2021 年中国先进封装市场规模约为 399.6 亿人民币,同比增长 13.7%。
【2.5D/3D 先进封装产能紧缺,龙头加大扩产力度】
全球先进封装市场玩家包括封测厂、晶圆厂和 IDM。根据 Yole 数据,OSAT厂在全球先进封装厂占据主导地位,2021 年全球市场份额 65%。
中国三大封测厂长电科技、通富微电、华天科技也在全球市场上占据领先地位。由于先进封装涉及诸多前道制造工艺,晶圆厂和 IDM 厂正在凭借前道工艺优势扩大市场占有率,2022 年,英特尔、台积电、三星在先进封装领域的营收分别位列全球第 3/4/6 位。

算力时代对堆叠封装需求提升,台积电、英特尔、三星等以及中国大陆的三大封测厂均布局 2.5D/3D 先进封装平台,以满足 AI 加速器和其他 HPC 芯片等高端市场快速增长的需求。

2.5D/3D 先进封装产能紧缺,龙头加大扩产力度。台积电 Cowos 是 2.5D 封装领域代表性工艺,台积电董事长刘德音在 2023 年 6 月表示的 CoWoS 产能供不应求,公司会将部分 InFO(扇出型晶圆级)封装产能转移,以便为 CoWoS 腾出更多产能满足客户需求。
根据电子时报,预计台积电 CoWoS 月产能将由目前的 8000 片晶圆增加至2023 年下半年的 11000 片,其中英伟达和 AMD 合计占据 70-80%产能。预计到 2024年底产能将进一步扩大至 20000 片晶圆,其中一半将由英伟达占据。
【先进封装设备国产化率整体低于 15%,国产替代空间广阔】
我国先进封装设备国产化率整体低于 15%,后道测试机、分选机是国产替代进展最快的环节,国产化率超过 10%;贴片机、划片机等后道设备国产化率仅约3%;TSV 深硅刻蚀、TSV 电镀设备、薄膜沉积等制程设备几乎都进口自海外。

国内以北方华创、中微公司、拓荆科技、盛美上海等为代表的公司突破海外垄断,国产化率有望逐步提升。
先进封装需求高增、产能紧缺,国内以长电科技、通富微电、华天科技为代表的封测厂也在加大 2.5D/3D 等先进封装的布局,在供应链自主可控趋势下,国产设备厂商迎来发展良机!

封测是我国半导体产业链中具备相对优势的环节,在高端工艺逐步普及过程中,封测与制造通过中道工序融合,是未来高端半导体链条的发展方向,极具发展潜力,华为发力封装赛道有望带动国内先进封装及设备材料需求。
我们建议关注:
1、封装测试厂商:长电科技、通富微电、甬矽电子、晶方科技,伟测科技;
2、先进封装材料公司:方邦股份、华正新材、兴森科技、强力新材、飞凯材料、德邦科技、南亚新材、沃格光电;
3、封装测试设备公司:长川科技、华峰测控、金海通、文一科技、芯碁微装、新益昌等。
我们筛选出以下潜力标的
士兰微(600460)2022 年 7 月 16 日公司互动:成都集佳目前为专业从事半导体功率器件和功率模块、MEMS传感器、光电子等封装与测试的企业。功率模块封装和 MEMS 传感器封装属于系统级封装,系统级封装是先进封装的一种类别。

赛微电子(300456)公司拥有目前业界领先的 TSV 绝缘层工艺和制造平台,已研发出包括深反应离子刻蚀等在内的 100 余项 MEMS 核心国际专利,相关专利技术可以推广移植至 2.5D 和 3D 晶圆级先进集成封装平台,可以为实现功能化晶圆级封装和三维集成提供保障。

文一科技(600520)公司正在研发的晶圆级封装设备属于先进封装专用工艺设备, 可以用于第三代半导体材料封装,传统封装采用引线框架作为载体进行封装,该设备基于 12 寸晶圆,可直接进行塑封,适用于 FoWLP 形式的封装。

参考资料:
开源证券-机械设备行业周报:需求高增产能紧缺,先进封装设备国产替代加速-231029.pdf
免责声明:
本文由投资顾问 : 冯利勇(执业证书编码:A1280620060001)、何军(执业证书编码:A1280621060001)、罗力川(登记编号:A1280622110002)等编辑整理,仅代表团队观点,任何投资建议不作为您投资的依据,您须独立作出投资决策,风险自担。请您确认自己具有相应的权利能力、行为能力、风险识别能力及风险承受能力,能够独立承担法律责任。所涉及个股仅作投资参考和学习交流,不作为买卖依据。投资有风险,入市需谨慎!